GAS SUPPLY SYSTEM
반도체 제조 공정 중 해당 공정에 필요한 원료 GAS를 원하는 조건(압력)으로 안전하고
청정이 유지된 상태에서 원료 GAS의 PURITY가 보존된 상태로 공급시키기 위한 장치입니다.
-
General Function
- Toxic gas piping - Corrosive gas piping - Liquid gas piping - Flammable gas piping - Inert gas piping - Toxic gas piping - Corrosive gas piping - Liquid gas piping - Flammable gas piping - Inert gas piping




| Parts | Description | Remarks |
|---|---|---|
| Enclosure | Material | SS41 2.3t Or 3.2t(For SiH4) |
| Wire-reinforced Safety Glass | Wire Depth 5t(Defence film Option) | |
| Color | Structure Powder | |
| Dimension | 1Bottle : 500 x 550 x 2000 | |
| 2Bottle : 800 x 550 x 2000 | ||
| 3Bottle : 1100 x 550 x 2000 | ||
| Panel | Material | SUS 304 (2t Polishing Plate) |
| Parts | Material | UHP Component(SUS316L VIM-VAR) |
| Controller | PLC | Omron CS-1 Series (CPU-45H) |
| Power | Heater Misapplication : 220V Single Phase 5A | |
| Heater Application : 220V Single Phase 25A | ||
| Touch | PROFACE GP - 577R(Color Type) | |
| Communication | Omron CLK Communication |
GAS SUPPLY SYSTEM
반도체 제조 공정 중 해당 공정에 필요한 원료 GAS를 원하는 조건(압력)으로 안전하고
청정이 유지된 상태에서 원료 GAS의 PURITY가 보존된 상태로 공급시키기 위한 장치입니다.
-
General Function
- PLC touch-screen controller - AC 110V/220V 60HZ - Analog resolution : 16bit, 4channel - Pressure Transducer : 4-20mA, 2 wire input - Networking : RS232 or Rs485 - Type : 1 supply-in, 4, 6, 8 supply-out - Purge : Nitrogen Type - High Supply Pressure Alarm - Low Supply Pressure Alarm



GAS SUPPLY SYSTEM
반도체 제조 공정 중 해당 공정에 필요한 원료 GAS를 원하는 조건(압력)으로 안전하고
청정이 유지된 상태에서 원료 GAS의 PURITY가 보존된 상태로 공급시키기 위한 장치입니다.
-
General Function
반도체 및 FPD, LCD 공정의 PROCESS 변화에 대응하여, MAIN설비의 GAS 공급 MODULE 및 CONTROL부를 축적된 기술력을 바탕으로 최적의 조건으로 설계, 재구성하여 공급하고 있습니다.





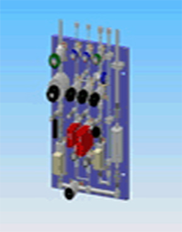
GAS SUPPLY SYSTEM
반도체 제조 공정 중 해당 공정에 필요한 원료 GAS를 원하는 조건(압력)으로 안전하고
청정이 유지된 상태에서 원료 GAS의 PURITY가 보존된 상태로 공급시키기 위한 장치입니다.
-
For Ultra-High Purity CVD and ALD Precursors
CVD 또는 ALD 설비로 안전하고 일정하게 UHP liquid precursors를 공급하는 장치로서 Dual canister를 통한 switchover 공급과 Solvent Rinsing으로 완전한 배관 cleaning을 할 수 있으며 공정의 중단없이 Auto-Refill할 수 있는 장치입니다.
-
For Dryer IPA
Wafer Cleaning을 위한 IPA 등의 Solvent를 Injection 또는 Bubbling 하여 Chamber로 안정적으로 공급하는 장치로서 Evaporation을 위한 온도 제어와 유량 제어를 할 수 있으며 각종 안전 장치를 구비하였습니다.
